公司新闻
1 - 二手真空电镀镀膜机可以电镀哪些产品,电镀的质量效果怎么样
2 - 东莞方形阵列钼片掩膜板-超薄金属掩模版加工-来图定制
3 - 分划板法测自组望远镜放大率的装置和方法与流程
4 - 掩模板的制作过程
5 - 有色光学玻璃
6 - 高精度三等标准金属线纹尺(线纹米尺)
7 - 不锈钢掩膜板激光定制加工溅射掩膜版高精切割
8 - 狙击手:幽灵战士2 瞄准镜分划板的使用方法
9 - K9光学玻璃窗口
10 - [发明专利]一种圆形截面拉伸试样尺寸测量装置在审
11 - 光学镜片的三大材质
12 - 光栅尺的原理及结构
13 - 不是所有的匀胶机都叫旋涂仪的!
14 - 直击SHOT Show:X4系统将游戏设定变成现实 提供自动补偿分划板
15 - catia螺纹孔在二维图上不显示_一个工程师必须了解的测量常识,你不知道怎么行
16 - [发明专利]一种透镜分划板及其制作方法有效
17 - 磨玻璃用什么砂轮好 玻璃磨边机都有哪些类型
18 - 光掩模在193nm波长光刻应用中生成雾状缺陷(haze)的预防.doc
19 - 三等金属线纹尺标准装置计量标准技术报告(钢直尺)
20 - 学好这七大步骤,让你精准捕捉标定板上的要素
匀胶铬版光掩模
发布时间:2023-12-06 来源:网络整理关键词标签: 分辨率 波长 穿透 寿命 所示
匀胶铬版光掩模是在平整的光掩模基板玻璃上通过蒸发或溅射沉积上厚约0. 1μm的铬-氧化铬膜而形成镀铬基板,再涂敷一层光刻胶或电子束抗蚀剂制成的匀胶铬版。它具有高敏感度、高分辨率、低缺陷密度的特点,是制作微细光掩模图形的理想感光性空白版。
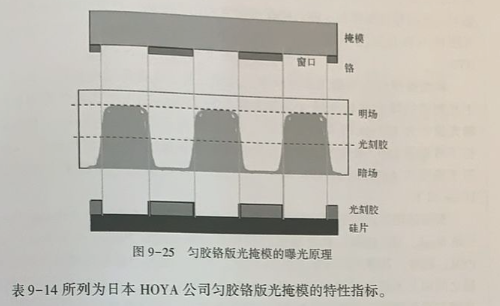
匀胶铬版的感光特性、分辨率完全取决于所涂敷的光刻胶或电子束抗蚀剂类型、品种,并通过光刻工艺得到所需的模版。在接触式光刻技术时代,用超微粒乳胶干版投片,虽然乳胶版具有制作容易、成本低的优势,但是由于其胶膜面软,存在易擦伤、沾污,清洁处理困难,使用寿命短等弱点。匀胶铬版的制作工艺相对复杂、技术难度大、成本高,但它具有分辨率高、缺陷低、耐磨、易清洁处理、使用寿命长的优势,适用于制作高精度、超微细图形,现已逐渐替代接触式乳胶干版掩模,成为集成电路掩模的关键材料。

匀胶铬版光掩模在刻蚀铬层后可生成简单的由黑区和白区组合的二元图像,因此也被称为二元掩模( Binary Intensity Mask, BIM),其曝光原理如图9-25所示。图中所示的是传统穿透式掩模,黑区完全不透光,白区完全透光,激光穿透白区作用在硅片相应位置上,使光刻胶反应产生光酸,通过后续的显影工艺将其去除或保留(取决于光刻胶是正型或负型的)后形成图像。匀胶铬版光掩模可应用的光学范围很广,覆盖了g线、i线,以及包括KrF (波长248nm)和ArF波长193nm) 的深紫外(Deep Ultraviolet, DUV)光刻工艺,曝光光源的波长极限决定了关键尺寸的技术节点。

